научное издание МГТУ им. Н.Э. Баумана
НАУКА и ОБРАЗОВАНИЕ
Издатель ФГБОУ ВПО "МГТУ им. Н.Э. Баумана". Эл № ФС 77 - 48211. ISSN 1994-0408
# 12, декабрь 2013
DOI: 10.7463/1213.0669629
УДК 004.076.4
ФГБУ НИЦ «Курчатовский институт», Москва, Российская Федерация
В современных электронных устройствах и системах используются три базисных пассивных двухконтактных элемента: сопротивление, емкость и индуктивность. При этом, в подавляющем большинстве современных цифровых интегральных схем и прочих микро- и наноэлектронных устройствах используются только сопротивления и емкости, а индуктивность является паразитным явлением. При выключении питания информация, накопленная в этих элементах (ток в сопротивлении и заряд в конденсаторе), теряется. Возможность сохранения информации в пассивных элементах может послужить основой совершенно новой парадигмы в электронной схемотехнике.
Помимо совершенствования цифровых вычислительных схем, которые потребуют гораздо меньшее количество активных элементов (например, биполярных транзисторов), пассивные элементы с эффектом памяти могут быть взяты за основу при разработке и создании ряда перспективных микро- и наноэлектронных устройств, включая самообучающиеся адаптивные системы управления и вычислений, основанные на нейроморфных принципах; перепрограммируемые ПЗУ со сверхвысокой плотностью записи информации; и переконфигурируемые вычислительные схемы и архитектуры, включая FPGA.
Основополагающая работа в области теории пассивных элементов с эффектом памяти, в которой было введено понятие «мемристор» (сопротивление с эффектом памяти) была опубликована в 1971 г. [1]. В этой работе было отмечено, что в фундаментальной теории электрических цепей отсутствует пассивный элемент, который связывает магнитный поток и заряд. Подобно пассивному сопротивлению, этот элемент (мемристор) связывает ток и напряжение, вместе с тем, величина сопротивления этого элемента после выключения питания зависит от полной временной зависимости сигнала (тока), прошедшего через него. Другими словами, состояние элемента после выключения питания зависит от эволюции его предыдущих состояний, т.е. элемент обладает эффектом памяти.
В настоящее время многие научные коллективы в области микроэлектроники ведут разработки технологии создания мемристора, а также возможности его интеграции в существующую КМОП-технологию. Были проведены многочисленные исследования по поиску материалов для создания подобного рода структур, изучению их структурных и электрофизических свойств и возможному применению структур с эффектом памяти. В результате исследований были установлены основные классы материалов с эффектом памяти такие как: оксиды металлов, твердые электролиты, материалы, изменяющие фазу под действием электрического тока, полимеры и пр. Все эти классы материалов обладают свойством переключения сопротивления, но различными механизмами, за счет которых это достигается. В литературе представлены элементы разной степени исследования, однако для ряда материалов удалось добиться стабильного мемристорного эффекта, получить на их основе устойчивый к переключению элемент и разработать для него модель функционирования. В данной статье представлен обзор таких структур с эффектом памяти на основе неорганических материалов, проведен анализ их характеристик и возможных вариантов их применения.
ХАЛЬКОГЕНИДЫ
Материалы, изменяющие фазу, изучались, начиная с 1960-х годов [2, 3]. Большинство таких материалов представляют собой халькогениды, которые под действием электрического поля и нагрева изменяют свое фазовое состояние. Различия в величинах электрического сопротивления и значениях оптических констант халькогенидов в аморфной и поликристаллической фазах позволяют использовать данные материалы для хранения данных.
При нагреве и последующем охлаждении халькогенид быстро переходит из аморфного состояния в поликристаллическое. Программирование элемента памяти на основе халькогенида происходит путем подачи энергетического импульса соответствующей амплитуды и длительности (рис. 1). Для установления высокого значения сопротивления элемента (состояние Reset или логический «0») используется короткий импульс с высокой амплитудой, достаточный для плавления материала, после чего происходит быстрое охлаждение элемента. Таким образом, халькогенид переходит в стабильное аморфное состояние. Для установления низкого значения сопротивления элемента (состояние Set или логическая «1») применяется длительный энергетический импульс с меньшей амплитудой, позволяющий нагреть материал до температуры выше температуры кристаллизации и ниже температуры плавления, при которой происходит его быстрая кристаллизация.
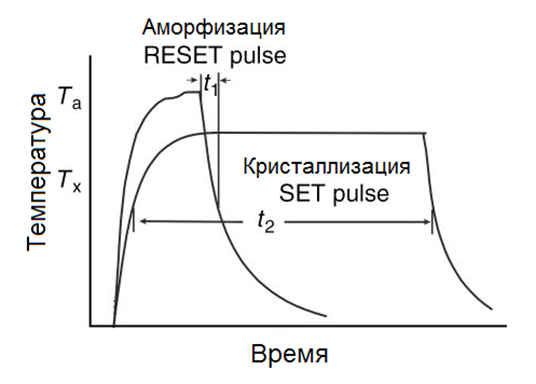
Рис. 1. Схематичная температурно - временная зависимость программирования состояния халькогенида, где Та и Тх – температуры плавления и кристаллизации халькогенида, соответственно [4].
Для нагрева халькогенида используется резистивный нагревательный элемент, который вместе со слоем самого халькогенида и электродами образует ячейку памяти. Когда к элементу приложено напряжение, протекающий через резистивный нагревательный элемент и халькогенид ток вызывает нагрев данных материалов.
Халькогениды состоят из одного или нескольких элементов VIгруппы периодической таблицы химических элементов. В литературе представлены различные по составу халькогенидные сплавы, такие как сплав германия, сурьмы и теллура [4-12], сплав германия и теллура [5, 8, 12-15], легированный серебром или индием сплав сурьмы и теллура [9, 16, 17], и др. [4, 6, 18, 19]. Однако в настоящее время наиболее используемыми являются сплавы Ge2Sb2Te5 и GeTe вследствие их высокой скорости кристаллизации [4, 15]. Скорость кристаллизации халькогенидов представляет собой одну из критических характеристик данных материалов, так как кристаллизация является наиболее длительным процессом и, тем самым, определяет максимальную скорость переключения элементов на основе халькогенидов.
В частности, в разработанной технологии памяти на основе фазового перехода (OvonicUnifiedmemory) используется сплав Ge2Sb2Te5 (сокращенно GST) [4, 20, 21]. Температура кристаллизации GSTсоставляет около 350°C, а время кристаллизации GST - около 20 нс [4], тогда как в общем случае для халькогенидов характерное время кристаллизации составляет не менее 60 нс [6,12,22,23]. В свою очередь, температура кристаллизации сплава GeTe составляет около 170°C, а время кристаллизации – менее 16 нс [15].
Кроме того, халькогениды обладают двумя отличительными свойствами, позволяющими использовать данные материалы для изготовления ячеек памяти – это сильная зависимость величины сопротивления материала от его фазового состояния и наличие порога переключения материала. Для наиболее распространенных халькогенидных сплавов максимальное сопротивление, присущее материалу в аморфном состоянии, составляет около 1 МОм, а минимальное, которым материал характеризуется в поликристаллическом состоянии, – около 1 кОм [6,10]. В среднем, отношение максимального сопротивления элемента к минимальному составляет не менее двух порядков [4, 6, 7, 18], что обеспечивает высокую различимость логических «0» и «1». Наличие же порога переключения у халькогенида обеспечивает протекание тока, достаточного для переключения элемента памяти на его основе из состояния Reset в состояние Set при достаточно низком приложенном напряжении (единицы вольт). Если бы у халькогенида отсутствовало пороговое электронное переключение, то для переключения элемента из состояния Reset в состояние Set потребовалось бы приложение очень высокого напряжения (не менее 100 В), что сильно ограничило бы их практическое применение. Характерная вольт-амперная характеристика элемента памяти на основе халькогенида представлена на рис. 2.

Рис. 2. Типичная вольт-амперная характеристика элемента памяти на основе халькогенида [5].
В аморфном состоянии (состояние Reset) халькогенидный сплав обладает высоким сопротивлением при значениях прикладываемого к нему напряжения ниже порогового (рис. 2). Когда прикладываемое к элементу напряжение достигает порогового значения, происходит быстрый рост проводимости халькогенида. Следует отметить, что данный рост проводимости является следствием чисто электронного переключения и не связан со структурными изменениями материала [5, 7, 20, 24, 25]. Далее приложенное напряжение обеспечивает протекание через элемент тока, достаточного для достижения необходимой температуры для кристаллизации халькогенида и, следовательно, переключения элемента в состояние Set. В свою очередь, чтобы переключить элемент из состояния Set в состояние Resetнеобходимо обеспечить протекание через элемент короткого импульса тока с высокой амплитудой, достаточного для расплава халькогенида и, следовательно, возврата материала в аморфное состояние. При этом длительность процесса перехода халькогенида в аморфное состояние составляет в среднем несколько наносекунд [4, 5]. В режиме чтения считывание значения сопротивления элемента происходит при напряжении, меньшем, чем пороговое (менее 0,4 В), при этом протекающий через элемент ток не приводит к изменению его состояния.
В зависимости от длительности и амплитуды, длительности фронтов импульса тока, протекающего через элемент, фазовое состояние халькогенида может быть аморфным, кристаллическим, а также частично аморфным или кристаллическим [12]. На рис. 3 показана экспериментальная зависимость значений сопротивления от плотности протекающего через них тока для элементов на основе GST и GeTe.

Рис. 3. Зависимость значений сопротивления от плотности протекающего через них тока для элементов на основе GST и GeTe [12].
Переключение элемента на основе GeTe из состояния Reset в состояние Set происходит более резко по сравнению с переключением элемента на основе GST. Переключения элементов из состояния Set в состояние Reset происходят достаточно плавно для обоих материалов. Такое плавное переключение позволяет получать различные промежуточные значения сопротивления элементов путем регулирования объемной доли аморфной фазы материала. Таким образом, подбирая необходимые значения амплитуды и длительности импульса тока, протекающего через элемент, можно обеспечить работу элемента памяти на основе халькогенида как в цифровом, так и в аналоговом режиме. То есть элементы на основе халькогенидов можно использовать не только в качестве ячеек памяти [4, 5, 7, 9-10, 15-18, 21-22, 24], но и в качестве синапсов в искусственных нейронных сетях [11, 26-28].
Элементы на основе халькогенидов характеризуются большим числом циклов перезаписи - от 109 до 1013 циклов [4, 20]. При этом установленные значения сопротивления элемента достаточно стабильно сохраняются при температуре 110 °С в течение 10 лет после программирования [4]. Однако существует ряд деградационных процессов, происходящих в данных элементах, которые могут существенно сократить срок их эксплуатации [29]. В частности, это расслоение материала халькогенида после неоднократного переключения элемента, в случае если при изготовлении элемента не была проведена достаточная подготовка поверхности подложки и не была обеспечена хорошая адгезия пленки [4]. Другим деградационным процессом является изменение элементного состава халькогенида вследствие диффузии материалов электродов при нагреве [30]. Также значительной проблемой элементов на основе халькогенидов является постепенное изменение сопротивления и порогового напряжения с течением времени [31]. Однако несмотря на указанные недостатки халькогенидов, крупные зарубежные разработчики микроэлектроники продолжают вести активные исследования в этой области с целью создания энергонезависимой памяти.
ТВЕРДЫЕ ЭЛЕКТРОЛИТЫ
Элементы на основе твердых электролитов, размещенных между двумя электродами, начали изучать еще в 1970-х годах [32]. Принцип действия таких элементов основан на эффекте формирования и растворения металлической проводящей нити в твердом электролите за счет миграции ионов металла электрода [33-37]. Формирование проводящей нити обеспечивает изменение значения сопротивления элемента на основе твердого электролита вплоть до трех порядков [35], что позволяет использовать данные материалы для хранения данных.
Один из электродов элемента на основе твердого электролита является электрохимически активным. Чаще всего в качестве материала такого электрода выступают серебро (Ag) [33-45] или медь (Cu) [42-49]. При этом второй электрод является электрохимически инертным металлом, например, платиновым Pt[36-38, 40-41, 45-46, 48-53], вольфрамовым (W) [33, 54-55], золотым (Au) [56] и др., [34, 35, 42, 53]. Анализ литературы показал, что наиболее часто используемыми твердыми электролитами являются следующие материалы – сульфиды германия (GexSy) [33, 37, 42-44, 53-56], селениды германия (GexSey) [34, 35, 39, 42-44, 50, 53-56], сульфид мышьяка (As2S3) [40,56], сульфид меди (Cu2S) [40, 46, 47, 57].
Механизм переключения элементов на основе твердых электролитов из высокоомного в низкоомное состояние достаточно хорошо изучен для наиболее распространенных электролитов. В литературе представлены результаты экспериментальных исследований, визуализирующие формирование нити проводимости в элементах на основе твердых электролитов, в частности, изображения, полученные методом сканирующей электронной микроскопии [34, 50, 55] и просвечивающей электронной микроскопии [38, 41, 45].
Схематично поэтапный процесс переключения элемента на основе твердого электролита, а также его вольт-амперная характеристика представлены на рис. 4. В начальный момент времени элемент на основе твердого электролита имеет высокое сопротивление (Reset), проводящая нить в электролите отсутствует (рис. 4а). При приложении положительного напряжения к электрохимически активному электроду, например, из серебра, происходит реакция окисления с образованием ионов серебра, а также их последующий дрейф через твердый электролит (рис. 4б). По достижении ионами противоположного электрода (электрохимически инертного, например, из платины) происходит реакция восстановления ионов серебра и процесс электрокристаллизации атомов серебра на поверхности платинового электрода. Последующий рост проводящей нити из атомов серебра происходит преимущественно в направлении электрохимически активного электрода (рис. 4в). Переключение элемента в состояние Set наблюдается, когда проводящая нить вырастает на всю ширину электролита и образует контакт с электрохимически активным электродом (рис. 4г). Элемент сохраняет состояние Set так долго, пока не будет приложено достаточное напряжение противоположной полярности, вызывающее электрохимическое растворение нити проводимости (рис. 4д) и переключение элемента в исходное состояние Reset (рис. 4а).

Рис. 4. Схема поэтапного процесса переключения элемента на основе твердого электролита совместно с его типичной вольт-амперной характеристикой [53].
Любой из рассмотренных этапов переключения элемента может ограничивать скорость всего процесса переключения. Прежде всего, скорость переключения элемента зависит от используемых материалов, в частности, от материала твердого электролита. Так для элементов на основе сульфида меди (Cu2S) время переключения в состояние Set и в состояние Reset составляет от 5 до 32 мкс [57]; на основе сульфида германия (GexSy) – 250 нс для переключения в состояние Set и 12 мс для переключения в состояние Reset[58]; на основе селенида германия (GexSey) – 50 нс для переключения в состояние Set и в состояние Reset[59]. При этом величины прикладываемого к элементам напряжения для их переключения не превышают 1,5 В.
В основном элементы на основе твердых электролитов являются биполярными, то есть переключение в таких элементах требует изменения полярности прикладываемого к ним напряжения. Но встречаются и униполярные элементы на основе твердых электролитов, переключение в которых происходит при одной и той же полярности прикладываемого напряжения [55].
Для элементов на основе наиболее распространенных твердых электролитов максимальное сопротивление (состояние элемента, при котором нить проводимости отсутствует) составляет не менее 107 Ом, а минимальное сопротивление (состояние элемента, при котором нить проводимости сформирована на всей толщине электролита) – около 104 Ом [35, 39, 42, 57, 59]. В свою очередь отношение максимального сопротивления элемента к минимальному составляет обычно не менее 4 порядков, что обеспечивает не только высокую различимость логических «0» и «1», но и возможность получения промежуточных значений сопротивления элемента [33]. В частности, в литературе представлены данные о том, что управление величиной сопротивления элементов на основе твердых электролитов возможно с помощью ограничения по току при измерении вольт-амперной характеристики элемента [33-35]. На рис. 5а представлена вольт-амперная характеристика элемента на основе сульфида германия GeS2, полученная при ограничении по току Icompl = 100 мкА, а на рис. 5б – зависимость значений сопротивления данного элемента от времени, прошедшего после его переключения, при разных значениях ограничения по току.

а)
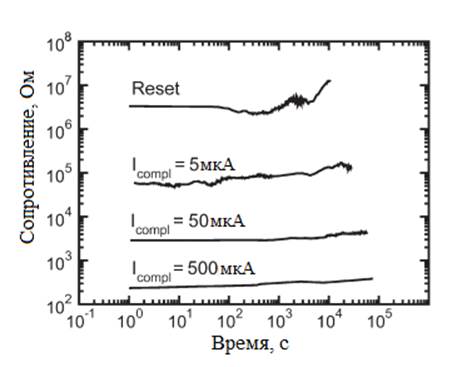
б)
Рис. 5. Вольт- амперная характеристика элемента на основе сульфида германия GeS2 (толщина слоя GeS2 – 60 нм, толщина Ag электрода – 30 нм) при ограничении по току Icompl = 100 мкА (а); и зависимость сопротивления данного элемента от времени, прошедшего после его переключения, при разных значениях ограничения по току Icompl (б) [33].
Установка ограничения по току позволяет увеличить значение сопротивления элемента на основе твердого электролита в состоянии Set (по сравнению со значением сопротивления элемента в состоянии Reset) более чем на два порядка. Такое управление величиной сопротивления элемента позволяет использовать один элемент для мультибитного хранения данных. Однако установленные значения сопротивления элемента стабильно сохраняются при комнатной температуре до 10 часов после программирования (рис. 5б). Также в элементах возникают проблемы с воспроизводимостью точных значений сопротивления, что в итоге ограничивает использование данных элементов в аналоговых схемах и, в частности, в качестве синапсов искусственных нейронных сетей [60, 61].
Помимо рассмотренных выше характеристик элементов на основе твердых электролитов важными, особенно для применений таких элементов в качестве ячеек памяти, являются время сохранения установившегося состояния элемента, а также его устойчивость к деградации. Проведенные испытания элементов показали, что установленное состояние Reset(1010 Ом) сохраняется на протяжении 10 лет без изменений, тогда как установленное состояние Set(105 Ом) спустя 10 лет увеличивается на два порядка [39]. В свою очередь испытания элементов на устойчивость к деградации показали противоположные результаты. После 105 циклов переключения сопротивление, соответствующее состоянию Reset, уменьшилось на два порядка, в то время как сопротивление, соответствующее состоянию Set, не изменилось. При этом также произошло увеличение значения порогового напряжения элемента (напряжения, при котором нить проводимости прорастает на всю толщину электролита) [39].
Тем не менее, в дальнейшем предполагается улучшение уровня устойчивости к деградации элементов на основе твердых электролитов за счет оптимизации процессов записи и стирания. А такие преимущественные характеристики данных элементов как низкое значение напряжения переключения и отличие значений сопротивлений в двух основных состояниях не менее чем на 4 порядка дают возможность использовать данные элементы для создания на их основе энергонезависимой памяти.
ОКСИДЫ
Впервые резистивное переключение в ультратонких пленках, имеющих структуру металл/оксид металла/металл, было обнаружено еще в 1960-х годах [62-64]. За прошедшие 50 лет было изучено большое количество материалов, которые могут быть использованы для создания элементов, обладающих способностью к переключению между двумя состояниями, характеризуемыми различными значениями сопротивлений, при приложении к ним соответствующего напряжения. Однако механизм переключения в элементах на основе оксидов металлов, расположенных между двумя электродами, еще достаточно плохо изучен и варьируется для различных материалов.
Наибольшее распространение в качестве материалов для изготовления на их основе элементов, обладающих способностью к резистивному переключению, получили следующие оксиды: TiOx[44, 65-74], NiOx[44, 65, 75-77], TaOx[65, 78], CuOx[44, 79], HfOx[65, 80-82], SiOx[83-85], перовскит SrTiO3 [86, 87, 88] и др. [44, 66]. Наблюдаемое резистивное переключение в элементах на основе оксидов происходит вследствие наличия в данных материалах различных дефектов и примесей, которые изменяют электронный транспоooрт в материале, а не его электронную структуру. Вследствие этого почти все изолирующие оксиды в большей или меньшей степени проявляют свойство резистивного переключения. При этом чтобы обеспечить управление переключением таких элементов, необходимо создавать дефекты в материалах либо в процессе изготовления элемента, либо после изготовления путем электрического воздействия на элемент (электроформирование).
При изготовлении элементов может изначально создаваться двухслойная структура между электродами, состоящая из оксида элемента и нестехиометрического оксида того же элемента (например, структуры вида: диоксид титана TiO2 / обедненный кислородом оксид титана TiO2-x[70, 71] или оксид тантала Ta2O5 / обедненный кислородом оксид тантала TaO2-x[78] и др.). При приложении напряжения к таким структурам кислородные вакансии диффундируют из изолирующего слоя оксида элемента в обедненный кислородом слой, создавая в нем канал проводимости и тем самым переключая структуру из высокоомного состояния в низкоомное. В случае создания структуры, состоящей только из изолирующего слоя оксида элемента, расположенного между электродами, для создания возможности переключения применяется электроформирование [65, 69, 88, 89]. Электроформирование структуры представляет собой мягкий пробой изолирующего оксида элемента при приложении к структуре высокого напряжения. Под действием высокого электрического поля атомы кислорода выбиваются из решетки и дрейфуют к электроду с положительным приложенным напряжением, создавая при этом дефекты в объеме оксида элемента. В итоге, данные дефекты (вакансии кислорода) образуют исходный канал проводимости для переключения структуры.
Переключения в структурах, изготовленных на основе оксидов элементов, подразделяются на два типа – биполярные и униполярные. Для некоторых оксидов, в частности TiOx [67], NiOx [75], SrTiO3 [87] переключения могут происходить как в биполярном, так и в униполярном (или неполярном, то есть не зависящем от полярности прикладываемого к элементу напряжения) режимах. Два возможных типа переключения в структурах на основе данных оксидов определяются главным образом структурой элементов, а не внутренними свойствами оксида, составляющего активный слой. В частности, на тип переключения данных структур влияют используемые материалы электродов [65], а также условия проведения процесса электроформирования в данных структурах [88]. На рис. 6 представлены основные режимы переключения структур на основе оксидов и их характерные вольт-амперные характеристики.

Рис. 6. Основные режимы переключения структур на основе оксидов и их характерные вольт-амперные характеристики: а) биполярный нелинейный режим; б) биполярный линейный режим; в) неполярный режим; г) неполярный пороговый режим [88].
Приложение напряжения к структурам на основе оксидов приводит к возникновению в них двух главных эффектов – электрического поля и нагрева. Оба этих эффекта определяют переключение элемента, однако степень их влияния зависит от структуры, материалов и условий электроформирования элемента. Биполярное нелинейное переключение элементов на основе оксидов металлов (рис. 6а), главным образом, зависит от величины электрического поля, подаваемого на элемент [70]. При таком типе переключения элемента канал проводимости формируется (состояние Set) и разрушается (состояние Reset) в вертикальном направлении сквозь слой оксида металла. При биполярном линейном переключении элементов на основе оксидов металлов (рис. 6б) наряду с электрическим полем определяющую для переключения роль играет и нагрев оксида металла [90]. Канал проводимости при этом постоянно сформирован в вертикальном направлении сквозь слой оксида металла, а изменение сопротивления элемента происходит за счет изменения состава, геометрии и размера канала проводимости. Неполярные режимы переключения элементов на основе оксидов металлов главным образом предопределяются эффектом нагрева оксида металла [71, 91]. Канал проводимости в элементах на основе оксидов металлов в случае неполярного переключения (рис. 6в) формируется за счет диффузии вакансий кислорода вследствие температурного градиента в элементе (состояние Set), а разрушается путем термического расплава (состояние Reset). Пороговое неполярное переключение элементов на основе оксидов металлов (рис. 6г) характеризуется переходом оксида металла в проводящее состояние при определенном уровне тока (состояние Set), а также резким разрывом канала проводимости вследствие недостаточного отвода тепла (состояние Reset).
Для элементов с резистивным переключением на основе наиболее часто используемых оксидов металлов режим переключения обычно является биполярным нелинейным. При этом следует заметить, что в данных элементах отсутствует точно определенное пороговое значение напряжения, при котором происходит их переключение [88]. На рис. 7 представлены динамические характеристики переключения элемента на основе оксида титана TiOx. Результаты исследований показывают, что для элементов на основе TiOx возможно переключение в состояние Set и состояние Reset за время, составляющее около 1 мкс, при приложении к элементу напряжения с амплитудой более 1 В. В то же время если амплитуда приложенного к элементу напряжения составляет около 0,5-0,6 В, то состояние элемента не изменяется в течение не менее 1 мс. Поэтому такие величины значения амплитуды прикладываемого к элементам напряжения используются для режима чтения.

Рис. 7. Динамические характеристики переключения элемента на основе оксида титана TiOx при приложении к нему импульсов напряжения различной длительности и амплитуды: а) переключение в высокоомное состояние; б) переключение в низкоомное состояние [72].
В литературе представлены результаты исследований скорости переключения элементов на основе оксидов металлов для различных материалов и структурных параметров элементов. Так, минимальные значения времени переключения элементов на основе оксидов металлов были получены для структур на основе следующих материалов: TiOx – 5 нс [92], TaOx – 10 нс [93], NiOx – 10 нс [94], HfOx – 40 нс [95].
Элементы на основе оксидов металлов характеризуются высокой устойчивостью к деградации при циклических переключениях элемента. Проведенные испытания показали, что элементы на основе наиболее распространенных оксидов металлов выдерживают не менее 105 циклов переключения [65, 66, 92]. В процессе проведения циклических переключений элементов на основе оксидов металлов наблюдаются изменения значений сопротивления элемента как в состоянии Set, так и в состоянии Reset. Однако в большей степени процесс деградации при циклических переключениях таких элементов определяется изменением значения сопротивления элемента в состоянии Reset, которое в ходе деградации уменьшается вплоть до значения сопротивления в состоянии Set[65, 74, 79, 92]. Также для элементов на основе оксидов металлов проводились исследования времени хранения установленных значений сопротивления. Проведенные испытания показали, что для наиболее распространенных оксидов металлов при комнатной температуре установленные состояния Reset и Set сохраняются на протяжении не менее 104 секунд без значительных изменений [65, 66].
Для элементов на основе наиболее распространенных оксидов металлов отношение значения сопротивления в состоянии Reset к значению сопротивления в состоянии Set составляет не менее 2-3 порядков [65, 70-71, 88, 92, 94-96]. Это обеспечивает не только высокую различимость логических «0» и «1», но и возможность получения промежуточных значений сопротивления элемента. В частности, в литературе представлены данные о том, что управление величиной сопротивления элемента на основе оксида титана TiOx в состоянии Reset возможно с помощью варьирования значения амплитуды прикладываемого к элементу напряжения [92]. На рис. 8а показано мультиуровневое переключение элемента на основе TiOx, а на рис. 8б – зависимость значений сопротивления данного элемента от времени, прошедшего после его переключения.

а)
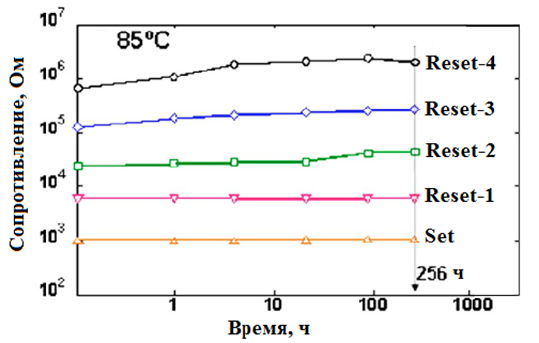
б)
Рис. 8. Мультиуровневое (4 уровня состояния Reset) переключение элемента на основе TiOx (а); и зависимость полученных мультиуровневых значений сопротивления данного элемента от времени, прошедшего после его переключения (б) [92].
Уменьшение амплитуды прикладываемого к элементу напряжения позволяет получить промежуточные, меньшие по величине, значения сопротивления элемента в состоянии Reset. В частности, для элемента на основе TiOx с отношением значения сопротивления в состоянии Reset к значению сопротивления в состоянии Setсоставляющим около 3 порядков можно получить 3 промежуточных значения сопротивления, отличающихся между собой примерно на 1 порядок (рис. 8). Важно отметить, что незначительные изменения установленных значений сопротивления элемента со временем наблюдаются только для состояний Reset(рис. 8б). Таким образом, деградация сопротивления элемента на основе TiOxс 4 уровнями состояния Resetпри температуре 85°С практически отсутствует в течение не менее 256 часов, что позволяет использовать данный элемент для мультибитного хранения данных [92]. Кроме того, такие элементы могут быть использованы в аналоговых схемах, а также в качестве синапсов искусственных нейронных сетей [97-102].
Интерес к использованию оксидов металлов в качестве материалов для элементов энергонезависимой памяти также определяется их совместимостью с технологиями КМОП (комплементарный металлооксидный полупроводник) и КНИ (кремний на изоляторе). Однако основным недостатком некоторых оксидов является плохая устойчивость электрофизических свойств созданных на их основе элементов при многократных циклических переключениях, а также изменение состояния элементов за счет самопроизвольной диффузии. Тем не менее, возможна минимизация данных недостатков рассматриваемых элементов за счет оптимизации процессов записи и стирания, а также подбора оптимальных структурных параметров элементов.
ЗАКЛЮЧЕНИЕ
В заключение отметим, что элементы на основе халькогенидов отличаются высокой устойчивостью к циклическим переключениям и достаточно высокой скоростью переключения. Для данных элементов также возможно получение промежуточных значений сопротивления, однако вследствие небольшой величины отношения максимального сопротивления элемента к минимальному использование таких элементов в аналоговых схемах достаточно затруднительно. Таким образом, элементы на основе халькогенидов могут успешно применяться в качестве элементов энергонезависимой памяти в случае минимизации основных процессов деградации, происходящих в них.
Структуры на основе твердых электролитов характеризуются большой величиной отношения максимального сопротивления элемента к минимальному. Это свойство дает возможность использовать такие элементы не только в цифровых, но и в аналоговых схемах. В частности, один элемент на основе твердого электролита может быть использован для мультибитного хранения данных. Однако для успешного применения таких элементов требуется решить проблему их низкой устойчивости к деградации.
Преимущественными характеристиками элементов на основе оксидов являются высокие скорости переключения, возможность получения промежуточных значений сопротивления, а также достаточно стабильные мультиуровневые переключения. Данные характеристики позволяют использовать структуры на основе оксидов как в цифровых, так и в аналоговых схемах, а также в качестве синапсов искусственных нейронных сетей. При этом особое внимание должно уделяться обеспечению устойчивости таких элементов к деградации.
Таким образом, рассмотренные структуры с эффектом памяти на основе халькогенидов, твердых электролитов и оксидов обладают как характерными преимуществами, так и недостатками, которые и определяют возможность их применения в качестве элементов цифровых и аналоговых схем, а также различных перспективных микро- и наноэлектронных устройствах.
Списоклитературы
1. Chua L.O. Memristor – the missing circuit element // IEEE Trans. Circuit Theory. 1971. Vol. 18, no. 5. P. 507-519. DOI: 10.1109/TCT.1971.1083337
2. Ovshinsky S.R. Reversible electrical switching phenomena in disordered structures // Phys. Rev. Lett. 1968. Vol. 21, no. 20. P. 1450-1453.
3. Feinleib J., deNeufville J., Moss S.C., Ovshinsky R.S. Rapid reversible light-induced crystallization of amorphous semiconductors. Appl. Phys. Lett., 1971, vol. 18, no. 6, pp. 254-257. DOI: 10.1063/1.1653653
4. Hudgens S., Johnson B. Overview of phase-change chalcogenide nonvolatile memory technology // MRS Bulletin. 2004. Vol. 29, no. 11. P. 829-832.
5. Beneventi G.B. Characterization and modeling of phase-change memories. LAP LAMBERT Academic Publishing, 2012. P. 1-109.
6. Wang F. Non-Volatile memory devices based on chalcogenide materials // In book: Flash Memories / Prof. I. Stievano (ed.). InTech Publ., 2011. P. 197-210. DOI: 10.5772/19286
7. Lai S. Current status of the phase change memory and its future // Proc. Int. Electron Devices Meeting (IEDM 03). IEEE Press, 2003. P. 10.1.1-10.1.4. DOI: 10.1109/IEDM.2003.1269271
8. Raoux S., Cabrera D., Devasia A., Kurinec S., Cheng H.-Y. Influence of dopants on the crystallization temperature, crystal structure, resistance, and threshold field for Ge2Sb2Te5 and GeTe phase change materials // E*PCOS, 2011. Available at: http://www.epcos.org/library/papers/pdf_2011/Oral-Papers/S4-03.pdf , accessed 01.10.2013.
9. Qureshi M.K., Srinivasan V., Rivers J.A. Scalable High Performance Main Memory System using phase-change memory technology // ISCA’09, June 20–24, 2009, Austin, Texas, USA. P. 24-33.
10. Pirovano A., Lacaita A.L., Benvenuti A., Pellizzer F., Hudgens S., Bez R. Scaling analysis of phase-change memory technology // Proc. of the IEEE Int. Electron Devices Meeting (IEDM 03). IEEE Press, 2003. P. 29.6.1-29.6.4. DOI: 10.1109/IEDM.2003.1269376
11. Li Y., Zhong Y., Xu L., Zhang J., Xu X., Sun H., Miao X. Ultrafast synaptic events in a chalcogenide memristor // Scientific Reports. 2013. Vol. 3:1619. P. 1-7. DOI: 10.1038/srep01619
12. Suri M., Bichler O., Querlioz D., Traoré B., Cueto O. Physical aspects of low power synapses based on phase change memory devices // J. Appl. Phys. 2012. Vol. 112. P. 054904. DOI: 10.1063/1.4749411
13. Saito Y., Sutou Y., Koike J. Crystallization behaviors of Si-doped GeTe phase change materials // E*PCOS. 2011. Available at: http://www.epcos.org/library/papers/pdf_2011/Posters-Contributed/PC-09.pdf , accessed 01.10.2013.
14. Simpson R.E., Fons P., Kolobov A.V., Krbal M., Tominaga J. Enhanced crystallization of GeTe from an Sb2Te3 template // Applied Physics Letters. 2012. Vol. 100. P. 021911. DOI:10.1063/1.3675635
15. Bruns G., Merkelbach P., Schlockermann C., Salinga M., Wuttig M. Nanosecond switching in GeTe phase change memory cells // Appl. Phys. Lett. 2009. Vol. 95. P. 043108. DOI: 10.1063/1.3191670
16. Hong S.-H., Bae B.-J., Lee H. Fast switching behavior of nanoscale Ag6In5Sb59Te30 based nanopillar type phase change memory // Nanotechnology. 2010. Vol. 21. P. 025703. DOI:10.1088/0957-4484/21/2/025703
17. Jeong J.-H., Lee H. S., Lee S., Lee T.S. Crystallization and memory programming characteristics of Ge-doped SbTe materials of varying Sb :Te ratio // J. Phys. D: Appl. Phys. 2009. Vol. 42. P. 035104. DOI:10.1088/0022-3727/42/3/035104
18. Burr G.W, Breitwisch M J., Franceschini M., Garetto D. Phase change memory technology // Journal of Vacuum Science and Technology B. 2010. Vol. 28, no. 2. P. 223-262.
19. Zalba B., Marın J. M., Cabeza L.F., Mehling H. Review on thermal energy storage with phase change: materials, heat transfer analysis and applications // Applied Thermal Engineering. 2003. Vol. 23. P. 251-283.
20. Gill M., Lowrey T., Park J. Ovonic unified memory - a high-performance nonvolatile memory technology for stand-alone memory and embedded applications // 2002 IEEE International Solid-State Circuits Conference (ISSCC). Session 12. 2002. P. 158-446. DOI: 10.1109/ISSCC.2002.992192
21. Zhang T., Liu B., Xia J.-L., Song Z.-T., Feng S.-L., Chen B. Structure and electrical properties of Ge2Sb2Te5 thin film used for Ovonic Unifed Memory // Chin. Phys. Lett. 2004. Vol. 21, no. 4. P. 741-743.
22. Honi H., Yi J.H., Park J.H., Ha Y.H., Baek I.G., Park S.O. A novel cell technology using N-doped GeSbTe films for phase change RAM // Symposium on VLSl. Technology Digest of Technical Papers. 2003. P. 177-178.
23. Chen Y.C., Rettner C.T., Raoux S., Burr G.W., Chen S.H. Ultra-thin phase-change bridge memory device using GeSb // International Electron Devices Meeting. San Francisco, CA, 2006. P. 777-780.
24. Pirovano A., Lacaita A.L., Benvenuti A., Pellizzer F., Bez R. Electronic switching in phase-change memories // IEEE Transactions on Electron Devices. 2004. Vol. 51, no. 3. P. 452-459. DOI: 10.1109/TED.2003.823243
25. Redaelli A., Pirovano A., Pellizzer F., Lacaita A.L., Ielmini D., Bez R. Electronic switching effect and phase-change transition in chalcogenide materials // IEEE Electron Device Letters. 2004. Vol. 25, no. 10. P. 684-686. DOI: 10.1109/LED.2004.836032
26. Kuzum D., Jeyasingh R.G D., Lee B., Wong H.-S.P. Nanoelectronic programmable synapses based on phase change materials for brain-inspired computing // Nano Lett. 2012. Vol. 12. P. 2179-2186. DOI: 10.1021/nl201040y
27. Suri M., Sousa V., Perniola L., Vuillaume D., DeSalvo B. Phase change memory for synaptic plasticity application in neuromorphic systems // Proceedings of International Joint Conference on Neural Networks. San Jose, California, USA. 2011. P. 619-624.
28. Suri M., Bichler O., Querlioz D., Cueto O., Perniola L. Phase change memory as synapse for ultra-dense neuromorphic systems: application to complex visual pattern extraction // IEEE International Electron Devices Meeting (IEDM). 2011. P. 4.4.1 - 4.4.4. DOI: 10.1109/IEDM.2011.6131488
29. Pirovano A., Redaelli A., Pellizzer F., Ottogalli F., Tosi M., Ielmini D. Reliability study of phase-change nonvolatile memories // IEEE Transactions on Device and Materials Reliability. 2004. Vol. 4, no. 3. P. 422-427. DOI: 10.1109/TDMR.2004.836724
30. Priviteraa S., Bongiomoa C., Riminia E., Zoncaa R., Pirovanoa R., Beza R. Amorphous-to-polycrystal transition in GeSbTe thin films // MRS Proceedings. 2003. Vol. 803. DOI: 10.1557/PROC-803-HH1.4
31. Ielmini D., Lacaita A. L., Mantegazza D. Recovery and Drift Dynamics of Resistance and Threshold Voltages in Phase-Change Memories // IEEE Transactions on Electron Devices. 2007. Vol. 54, no. 2. P. 308-315. DOI: 10.1109/TED.2006.888752
32. Hirose Y., Hirose H. Polarity-dependent memory switching and behavior of Ag dendrite in Ag photodoped amorphous As2S3 films // J. Appl. Phys. 1976. Vol. 47. P. 2767. DOI: 10.1063/1.322942
33. Russo U., Kamalanathan D., Ielmini D., Lacaita A.L., Kozicki M.N. Study of multilevel programming in programmable metallization cell (PMC) memory // IEEE Transactions on Electron Devices. 2009. Vol. 56, no. 5. P. 1040-1047. DOI: 10.1109/TED.2009.2016019
34. Kozicki M.N., Park M., Mitkova M. Nanoscale memory elements based on solid-state electrolytes // IEEE Transactions on Nanotechnology. 2005. Vol. 4, no. 3. P. 31-338. DOI: 0.1109/TNANO.2005.846936
35. Kund M., Beitel G., Pinnow C.-U., Röhr T., Schumann J. Conductive bridging RAM (CBRAM) an emerging non-volatile memory technology scalable to sub 20 nm // IEEE International Electron Devices Meeting, 2005. IEDM Technical Digest. 2005. P. 754-757. DOI: 10.1109/IEDM.2005.1609463
36. Waser R. Electrochemical and thermochemical memories // IEEE International Electron Devices Meeting, 2008. IEDM 2008. IEEE Press, 2008. P. 1-4. DOI: 10.1109/IEDM.2008.4796675
37. Waser R. Resistive non-volatile memory devices // Microelectronic Engineering. 2009. Vol. 86. P. 1925-1928. DOI: 10.1016/j.mee.2009.03.132
38. Liu Q, Long S., Lv H., Wang W., Niu J. Controllable growth of nanoscale conductive filaments in solid-electrolyts based ReRAM by using a metal nanocrystal covered bottom electrode // Acsnano. 2010. Vol. 4, no. 10. P. 6162-6168. DOI: 10.1021/nn1017582
39. Symanczyk R., Balakrishnan M., Gopalan C., Happ T., Kozicki M., Kund M., Mikolajick T., Mitkova M., Park M., Pinnow C., Robertson J., Ufert K. Electrical characterization of solid state ionic memory elements // Proceedings of the 2003 Non-Volatile Memory Technology Symposium. San Diego, California. 2003. P. 17-1.
40. Lu W., Jeong D.S., Kozicki M., Waser R. Electrochemical metallization cells-blending nanoionics into nanoelectronics // MRS Bulletin. 2012. Vol. 37. P. 124-130. DOI: 10.1557/mrs.2012.5
41. Yang Y., Gao P., Gaba S., Chang T., Pan X., Lu W. Observation of conducting filament growth in nanoscale resistive memories // Nature communications. 2012. Vol. 3, no. 732. P. 1‑8. DOI: 10.1038/ncomms1737
42. Kozicki M., Gopalan C., Balakrishnan M., Park M., Mitkova M. Nonvolatile memory based on solid electrolytes // Proceedings of the 2004 Non-Volatile Memory Technology Symposium. IEEE Press, 2004. P. 10-17. DOI: 10.1109/NVMT.2004.1380792
43. Kozicki M., Balakrishnan M., Gopalan C., Ratnakumar C., Mitkova M. Programmable metallization cell memory based on Ag-Ge-S and Cu-Ge-S solid electrolytes // Proceedings of the 2005 Non-Volatile Memory Technology Symposium. IEEE Press, 2005. P. 83-89. DOI: 10.1109/NVMT.2005.1541405
44. Burr G. W., KurdiB. N., Scott J. C., Lam C.H., Gopalakrishnan K., Shenoy R. S. Overview of candidate device technologies for storage-class memory // IBM J. RES. & DEV. 2008. Vol. 52, no. 4. P. 449-464.
45. Liu Q., Sun J., Lv H., Long S., Yin K., Wan N., Li Y. Real-time observation on dynamic growt/dissolution of conductive filaments in oxide-electrolyte-based ReRAM // Adv. Mater. 2012. P. 1-6. DOI: 10.1002/adma.201104104
46. Hasegawa T., Terabe K., Tsuruoka T., Aono M. Atomic switch atom/ion movement controlled devices for beyond von-Neumann computers // Adv. Mater. 2012. Vol. 24. P. 252‑267. DOI: 10.1002/adma.201102597
47. Sakamoto T., Sunamura H., Kawaura H., Hasegawa T., Nakayama T. Nanometer-scale switches using copper sulfide // Appl. Phys. Lett. 2003. Vol. 82. P. 3032-3034. DOI: 10.1063/1.1572964
48. Sakamoto T., Lister K., Banno N., Hasegawa T. Terabe K., Aono M. Electronic transport in Ta2O5 resistive switch // Appl. Phys. Lett. 2007. Vol. 91. P. 092110. DOI: 10.1063/1.2777170
49. Haemori M., Nagata T., Chikyow T. Impact of Cu electrode on switching behavior in a Cu/HfO2/Pt structure and resultant Cu ion diffusion // Appl. Phys. Express. 2009. Vol. 2. P. 061401. DOI: 10.1143/APEX.2.061401
50. Guo X., Schindler C., Menzel S., Waser R. Understanding the switching-off mechanism in Ag+ migration based resistively switching model systems // Appl. Phys. Lett. 2007. Vol. 91. P. 133513. DOI: 10.1063/1.2793686
51. Tsuruoka T., Terabe K., Hasegawa T., Aono M. Forming and switching mechanisms of a cation-migration-based oxide resistive memory // Nanotechnology. 2010. Vol. 21. P. 425205-425213. DOI: 10.1088/0957-4484/21/42/425205
52. Valov I., Staikov G. Nucleation and growth phenomena in nanosized electrochemical systems for resistive switching memories // J. Solid State Electrochem. 2013. Vol. 17. P. 365-371. DOI: 10.1007/s10008-012-1890-5
53. Valov I., Waser R., Jameson J.R., Kozicki M.N. Electrochemical metallization memories—fundamentals, applications, prospects // Nanotechnology. 2011. Vol. 22. P. 254003-254025. DOI:10.1088/0957-4484/22/25/254003
54. Bruchhaus R., Honal M., Symanczyk R., Kunda M. Selection of optimized materials for CBRAM based on HT-XRD and electrical test results // Journal of the Electrochemical Society. 2009. Vol. 156, no. 9. P. H729-H733.
55. Schindler C., Chandran S., Thermadam P., Waser R., Kozicki M. Bipolar and unipolar resistive switching in Cu-doped SiO2 // IEEE Transactions on Electron Devices. 2007. Vol. 54, no. 10. P. 2762-2768. DOI: 10.1109/TED.2007.904402
56. Stratan I., Tsiulyanu D., Eisele I. A programmable metallization cell based on Ag-As2S3 // Journal of Optoelectronics and Advanced Materials. 2006. Vol. 8, no. 6. P. 2117-2119.
57. Kaeriyama S., Sakamoto T., Sunamura H., Mizuno M. A nonvolatile programmable solid-electrolyte nanometer switch // IEEE Journal of Solid-State Circuits. 2005. Vol. 40, no. 1. P. 168-176. DOI: 10.1109/JSSC.2004.837244
58. Gopalan C., Ma Y., Gallo T., Wang J., Runnion E., Saenz J. Demonstration of conductive bridging random access memory (CBRAM) in logic CMOS process // Solid-State Electronics. 2011. Vol. 58. P. 54-61. DOI: 10.1016/j.sse.2010.11.024
59. Dietrich S., Angerbauer M., Ivanov M., Gogl D., Hoenigschmid H. A nonvolatile 2-Mbit CBRAM memory core featuring advanced read and program control // IEEE Journal of Solid-State Circuits. 2007. Vol. 42, no. 4. P. 839-845. DOI: 10.1109/JSSC.2007.892207
60. Yu S., Wong H.-S.P. Modeling the switching dynamics of programmable-metallization-cell (PMC) memory and its application as synapse device for a neuromorphic computation system // IEEE International Electron Devices Meeting (IEDM), 2010. IEEE Press, 2010. P. 22.1.1- 22.1.4. DOI: 10.1109/IEDM.2010.5703410
61. Swaroop B., West W.C., Martinez G., Kozicki M.N., Akersf L.A. Programmable current mode Hebbian learning neural network using programmable metallization cell // Proceedings of the IEEE International Symposium on Circuits and System (ISCAS’98), Monterey. 1998. Vol. 3. P. 33-36. DOI: 10.1109/ISCAS.1998.703888
62. Hickmott T.W. Low frequency negative resistance in thin anodic oxide films // Journal of Applied Physics. 1962. Vol. 33, no. 9. P. 2669-2682. DOI: 10.1088/0957-4484/23/3/035201
63. Gibbons J.F., Beadle W.E. Switching properties of thin NiO films // Solid-State Electronics. 1964. Vol. 7. P. 785-797. DOI: 10.1088/0957-4484/23/3/035201
64. Dearnaley G., Stoneham A.M., Morgan D.V. Electrical phenomena in amorphous oxide films // Rep. Prog. Phys. 1970. Vol. 33. P. 1129-1191. DOI: 10.1088/0957-4484/23/3/035201
65. Wong P. H.-S., Lee H.-Y., Yu S., Chen Y.-S., Wu Y., Chen P.-S., Lee B., Chen F.T., Tsai M.-J. Metal–oxide RRAM // Proceedings of the IEEE. 2012. Vol. 100, no. 6. P. 1951-1970. DOI: 10.1109/JPROC.2012.2190369
66. Akinaga H., Shima H. Resistive random access memory (ReRAM) based on metal oxides // Proceedings of the IEEE. 2010. Vol. 98, no. 12. P. 2237-2251. DOI: 10.1109/JPROC.2010.2070830
67. Sun X., Li G., Zhang X., Ding L., Zhang W. Coexistence of bipolar and unipolar resistive switching behaviours in Au/SrTiO3/Pt cells // Journal of Physics D: Applied Physics. 2011. Vol. 44, no. 12. P. 1-5. DOI :10.1088/0022-3727/44/12/125404
68. Kim K.M., Choi B.J., Hwang C.S. Localized switching mechanism in resistive switching of atomic-layer-deposited TiO2 thin films // Appl. Phys. Lett. 2007. Vol. 90. P. 242906. DOI: 10.1063/1.2748312
69. Jeong D.S., Schroeder H., Breuer U., Waser R. Characteristic electroforming behavior in Pt/TiO2/Pt resistive switching cells depending on atmosphere // J. Appl. Phys. 2008. Vol. 104. P. 123716. DOI: 10.1063/1.3043879
70. Yang J.J., Pickett M.D., Li X., Ohlberg D.A., Stewart D.R., Williams R.S. Memristive switching mechanism for metal/oxide/metal nanodevice // Nature Nanotechnology. 2008. Vol. 3. P. 429-433. DOI:10.1038/nnano.2008.160
71. Kwon D.-H., Kim K. M., Jang J. H., Jeon J. M., Lee M. H., Kim G. H., Li X.-S., Park G.-S., Lee B., Han S., Kim M., Hwang C.S. Atomic structure of conducting nanofilaments in TiO2 resistive switching memory // Nature Nanotechnology. 2010. Vol. 5. P. 148-153. DOI: 10.1038/NNANO.2009.456
72. Alibart F., Gao L., Hoskins B.D., Strukov D.B. High precision tuning of state for memristive devices by adaptable variation-tolerant algorithm // Nanotechnology. 2012. Vol. 23. P. 075201. DOI: 10.1088/0957-4484/23/7/075201
73. Pickett M.D., Strukov D.B., Borghetti J.L., Yang J.J., Snider G.S. Switching dynamics in titanium dioxide memristive devices // J. Appl. Phys. 2009. Vol. 106. P. 074508. DOI: 10.1063/1.3236506
74. Kim K. M., Han S., Hwang C.S. Electronic bipolar resistance switching in an anti-serially connected Pt/TiO2/Pt structure for improved reliability // Nanotechnology. 2012. Vol. 23. P. 035201. DOI: 10.1088/0957-4484/23/3/035201
75. Goux L., Lisoni J.D., Jurczak M., Wouters D.J., Courtade L. Coexistence of the bipolar and unipolar resistive-switching modes in NiO cells made by thermal oxidation of Ni layers // J. Appl. Phys. 2010. Vol. 107. P. 024512. DOI: 10.1063/1.3275426
76. Ielmini D., Nardi F., Cagli C. Physical models of size-dependent nanofilament formation and rupture in NiO resistive switching memories // Nanotechnology. 2011. Vol. 22. P. 254022. DOI: 10.1088/0957-4484/22/25/254022
77. Nardi F., Ielmini D., Cagli C., Spiga S., Fanciulli M., Goux L., Wouters D.J. Sub-10 μA reset in NiO-based resistive switching memory (RRAM) cells // IEEE International Memory Workshop (IMW), 16-19 May 2010, Seoul. 2010. P. 1-4. DOI: 10.1109/IMW.2010.5488317
78. Hur J.-H., Kim K. M., Chang M., Lee S. R., Lee D., Lee C.B., Lee M.-J., Kim Y.-B., Kim C.-J., Chung U.-I. Modeling for multilevel switching in oxide-based bipolar resistive memory // Nanotechnology. 2012. Vol. 23. P. 225702. DOI: 10.1088/0957-4484/23/22/225702
79. Chen A., Haddad S., Wu Y.-C., Fang T.-N., Lan Z. Non-volatile resistive switching for advanced memory applications // IEEE International Electron Devices Meeting, 2005. IEDM Technical Digest. 2005. P. 746-749. DOI: 10.1109/IEDM.2005.1609461
80. Goux L., Chen Y.-Y., Pantisano L., Wang X.-P., Groeseneken G. On the gradual unipolar and bipolar resistive switching of TiN\HfO2\Pt memory systems // Electrochemical and Solid-State Letters. 2010. Vol. 13, no. 6. P. G54-G56.
81. Govoreanu B., Kar G.S., Chen Y.-Y., Paraschiv V., Kubicek S., Fantini A., Radu I.P., Goux L., Clima S., Degraeve R., Jossart N., Richard O., Vandeweyer T., Seo K., Hendrickx P., Pourtois G., Bender H., Altimime L., Wouters D.J., Kittl J.A., Jurczak M. 10x10nm2 Hf/HfOx crossbar resistive RAM with excellent performance, reliability and low-energy operation // 2011 IEEE International Electron Devices Meeting (IEDM). 2011. P. 729-732. DOI: 10.1109/IEDM.2011.6131652
82. Goux L., Czarnecki P., Chen Y.-Y., Pantisano L., Wang X.P. Evidences of oxygen-mediated resistive-switching mechanism in TiN\HfO2\Pt cell // Appl. Phys. Lett. 2010. Vol. 97. P. 243509. DOI: 10.1063/1.3527086
83. Park W.I., Yoon J.M., Park M., Lee J., Kim S.K. Self-assembly-induced formation of high-density silicon oxide memristor nanostructures on graphene and metal electrodes // Nano Lett. 2012. Vol. 12. P. 1235-1240. DOI: dx.doi.org/10.1021/nl203597d
84. Mehonic A., Cueff S., Wojdak M., Hudziak S., Jambois O. Resistive switching in silicon suboxide films // Journal of Applied Physics. 2012. Vol. 111. P. 074507. DOI: 10.1063/1.3701581
85. Jamaa M.H.B., Carrara S., Georgiou J., Archontas N., De Micheli G. Fabrication of memristors with poly-crystalline silicon nanowires // 9th IEEE Conference on Nanotechnology. IEEE-NANO 2009. 2009. P. 152-154.
86. Janousch M., Meijer G.I., Staub U., Delley B., Karg S.F. Role of oxygen vacancies in Cr-doped SrTiO3 for resistance-change memory // Adv. Mater. 2007. Vol. 19. P. 2232-2235. DOI: 10.1002/adma.200602915
87. Sun X., Li G., Zhang X., Ding L., Zhang W. Coexistence of the bipolar and unipolar resistive switching behaviours in Au\SrTiO3\Pt cells // J. Phys. D: Appl. Phys. 2011. Vol. 44. P. 125404. DOI: 10.1088/0022-3727/44/12/125404
88. Yang J.J., Strukov D.B., Stewart D.R. Memristive devices for computing // Nature Nanotechnology. 2013. Vol. 8. P. 13-24. DOI: 10.1038/NNANO.2012.240
89. Yang J. J., Miao F., Pickett M. D., Ohlberg D. A., Stewart D. R. The mechanism of electroforming of metal oxide memristive switches // Nanotechnology. 2009. Vol. 20. P. 215201. DOI:10.1088/0957-4484/20/21/215201
90. Miao F., Strachan J.P., Yang J.J., Zhang M.-X., Goldfarb I. Anatomy of a nanoscale conduction channel reveals the mechanism of a high-performance memristor // Adv. Mater. 2011. Vol. 23. P. 5633-5640. DOI: 10.1002/adma.201103379
91. Pickett M.D., Borghetti J., Yang J.J., Medeiros-Ribeiro G., Williams R.S. Coexistence of memristance and negative differential resistance in a nanoscale metal-oxide-metal system // Adv. Mater. 2011. Vol. 23. P. 1730-1733. DOI: 10.1002/adma.201004497
92. Yoshida C., Tsunoda K., Noshiro H., Sugiyama Y. High-speed resistive switching in Pt/TiO2/TiN film for nonvolatile memory application // Appl. Phys. Lett. 2007. Vol. 91. P. 223510. DOI: 10.1063/1.2818691
93. Wei Z., Kanzawa Y., Arita K., Katoh Y., Kawai K., Muraoka S., Mitani S., Fujii S., Katayama K., Iijima M., Mikawa T., Ninomiya T., Miyanaga R., Kawashima Y., Tsuji K., Himeno A., Okada T., Azuma R., Shimakawa K., Sugaya H., Takagi T., Yasuhara R., Horiba K., Kumigashira H., Oshima M. Highly reliable TaOx ReRAM and direct evidence of redox reaction mechanism // 2008 IEEE International Electron Devices Meeting (IEDM 2008). 2008. P. 293-296. DOI:10.1109/IEDM.2008.4796676
94. Lee M.-J., Han S., Jeon S. H., Park B. H., Kang B. S. Electrical manipulation of nanofilaments in transition-metal oxides for resistance-based memory // Nano Lett. 2009. Vol. 9, no. 4. P. 1476-1481. DOI: 10.1021/nl803387q
95. Chen Y.S., Lee H.Y., Chen P.S., Gu P.Y., Chen C.W., Lin W.P., Liu W.H., Hsu Y.Y., Sheu S.S., Chiang P.-C., Chen W.S., Chen F.T., Lien C.H., Tsai M.J. Highly scalable hafnium oxide memory with improvements of resistive distribution and read disturb immunity // 2009 IEEE International Electron Devices Meeting (IEDM 2009). 2009. P. 1-4. DOI: 10.1109/IEDM.2009.5424411
96. Seo S., Lee M.J., Seo D.H., Jeoung E.J., Suh D.-H. Reproducible resistance switching in polycrystalline NiO films // Appl. Phys. Lett. 2004. Vol. 85, no. 23. P. 5655-5657. DOI: 10.1063/1.1831560
97. Sah M.P., Yang C., Kim H., Chua L. A voltage mode memristor bridge synaptic circuit with memristor emulators // Sensors. 2012. Vol. 12. P. 3587-3604. DOI: 10.3390/s120303587
98. Indiveria G., Linares-Barrancob B., Legensteinc R., Deligeorgisd G., Prodromakise T. Integration of nanoscale memristor synapses in neuromorphic computing architectures // Nanotechnology. 2013. Vol. 24, no. 38. P. 384010. DOI:10.1088/0957-4484/24/38/384010
99. Jo S.H., Chang T., Ebong I., Bhadviya B.B. Nanoscale memristor device as synapse in neuromorphic systems // Nano Lett. 2010. Vol. 10. P. 1297-1301. DOI: 10.1021/nl904092h
100. Laiho M., Lehtonen E., Russell A., Dudek P. Memristive synapses are becoming reality // Institute of Neuromorphic Engineering. 2010. P. 1-3. DOI: 0.2417/1201011.003396
101. Chabi D., Zhao W., Querlioz D., Klein J.-O. Robust neural logic block based on memristor crossbar array // IEEE/ACM International Symposium on Nanoscale Architectures. 2011. P. 137-143. DOI: 10.1109/NANOARCH.2011.5941495
102. Thomas A. Memristor-based neural networks // J. Phys. D: Appl. Phys. 2013. Vol. 46. P. 093001. DOI: 10.1088/0022-3727/46/9/093001
Публикации с ключевыми словами: мемристор, оксиды металлов, халькогениды, твердые электролиты, энергонезависимая память
Публикации со словами: мемристор, оксиды металлов, халькогениды, твердые электролиты, энергонезависимая память
Смотри также:
Тематические рубрики:
| Авторы |
| Пресс-релизы |
| Библиотека |
| Конференции |
| Выставки |
| О проекте |
| Телефон: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) |
|
||||
| © 2003-2024 «Наука и образование» Перепечатка материалов журнала без согласования с редакцией запрещена Тел.: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) | |||||



