научное издание МГТУ им. Н.Э. Баумана
НАУКА и ОБРАЗОВАНИЕ
Издатель ФГБОУ ВПО "МГТУ им. Н.Э. Баумана". Эл № ФС 77 - 48211. ISSN 1994-0408
# 12, декабрь 2011
УДК 621.923
МГТУ им. Н.Э. Баумана
Настоящий этап развития нано- и микросистемной техники и наноэлектроники обуславливает повышенный интерес к методам финишной обработки подложек:
- абразивной доводке свободным абразивом;
- абразивной доводке связанным абразивом;
- абразивному полированию;
- химико-механическому полированию.
Методы свободным абразивом (lapping) и связанным абразивом (grinding) находят широкое применение для односторонней и двусторонней обработки подложек из полупроводниковых материалов, природных и искусственных монокристаллов, оптического стекла, керамики и других материалов в частности, одним из актуальных применений обработки связанным абразивом является утонение кремневых подложек после операции соединения слоев микросистемы. Например, при производстве микроминиатюрных датчиков давления для измерения внутриглазного давления технологический процесс изготовления включает этапы, представленные на рис. 1:
- нанесение эпитаксиального слоя (3) кремния n-типа на подложку 1 из монокристаллического кремния p-типа;
- анизотропное жидкостное химическое травление лицевой поверхности подложки 2 с целью получения лунок пирамидальной формы;
- подготовка поверхностей подложек 1,2 с последующим соединением методом прямого сплавления;
- электрохимическое травление подложки 1 с остановом на границе эпитаксиального слоя;
- утонение подложки 2 до вскрытия полостей.

Рис. 1. Некоторые этапы изготовления датчика давления.
Другим характерным примером применения методов финишной обработки подложек является изготовление структур кремний на диэлектрике (КНД) или кремний на изоляторе (КНИ), которые используются в микроэлектронике, а также в микросистемной технике для создания высокотемпературных и радиационно-стойких датчиков. В настоящее время структуры КНД рассматриваются также как наиболее перспективный материал для производства КМОП и БиКМОП ИС на основании того, что по сравнению с <объемными> СБИС их применение позволяет увеличить
- быстродействие за счет уменьшения паразитных емкостей;
- степень интеграции с переходом на физическую, а не электрическую изоляцию элементов, в результате также полностью устраняется эффект <защелкивания>;
- стойкость к внешним воздействующим факторам.
Ведущие электронные фирмы за рубежом интенсивно занимаются разработками технологий КНД и приборов на их основе. На данный момент сформировались следующие технологические направления:
- ионный синтез захороненных диэлектрических слоев (SIMOX),
- сращивание пластин (WAFER BONDING),
- <управляемый скол> ( SMART CUT ),
- эпитаксия на пористом кремнии.
До промышленного производства доведена технология SIMOX. Фирмы SOITEC (Франция), Ibis Technology Corporation (США) предлагают пластины КНД диаметром 100-200 мм, имеющие захороненный диэлектрик толщиной 0.08-0.4 мкм и приборный слой кремния 0.05-0.2 мкм с плотностью дислокаций 1-5 × 10-4 см -2. Стоимость КНД -структур составляет ~ US$125 за пластины диаметром 100 мм, ~ US$250 – 150 мм и свыше US$500 за пластины 200 мм. Высокая цена структур обусловлена использованием в технологии SIMOX нестандартного сильноточного ускорителя ионов кислорода. Ожидается, что эта величина станет запредельной при неизбежном переходе полупроводниковой промышленности в будущем на работу с пластинами 300 мм. Высокие значения плотности дефектов в рабочих слоях и цена структур являются серьезным препятствием для применения SIMOX-пластин в массовом производстве электронных изделий.
Технология WAFER BONDING (WB) существует в двух вариантах:
- толстые (>1мкм) и
- субмикронные
слои кремния на диэлектрике. В первом случае получают практически бездефектные рабочие структуры, поэтому эта технология не имеет конкурентов в области силовой электроники и аналоговых приборов. Однако в субмикронном варианте, предназначенном, как и SIMOX, для изготовления низковольтной быстродействующей аппаратуры на базе КМОП и БиКМОП КНД ИС, проблемы остались прежними: высокая плотность дефектов (~104 см -2), и аналогичная цена. Фирма SiBond (США) предлагает на рынке электронных материалов WB-пластины, выполненные в обоих вариантах и имеющие рабочие слои кремни 0.05 – 700 мкм на изолирующей пленке оксида кремния толщиной 0.01 - 3.0 мкм.
Технология SMART CUT (SC) включает в себя элементы обоих представленных выше технологий, а именно: ионную имплантацию и сращивание пластин. Несмотря на то, что в технологии SC используется стандартное производственное оборудование, она имеет серьёзные недостатки: большое число технологических операций, высокая цена изделия и ограниченная возможность варьировать параметрами КНД-структуры. Фирма SOITEC (Франция) выставляет на рынок SC-пластины, указывая основные параметры без интервала допустимых изменений: толщины рабочего слоя кремния и диэлектрика, соответственно, 0.2 мкм и 0.4 мкм. Однако низкая плотность дислокаций в структурах, составляющая величину 102 см -2, привлекает внимание производителей электронной аппаратуры.
На рис. 2 показаны некоторые этапы получения структур КНД методом сращивания подложек. Две кремниевых подложки, одна из которых покрыта слоем диоксида кремния (SiO2) сращиваются между собой методом прямого сплавления, затем следует утонение одной из подложек до заданной толщины путем абразивной доводки связанным абразивом и химико-механического полирования.
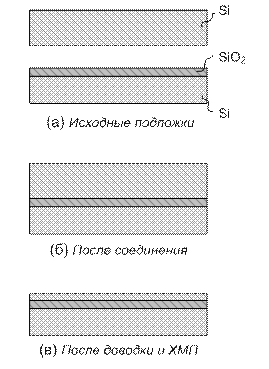
Рис. 2. Изготовление подложек КНИ методом сращивания подложек.
Получение заданной толщины слоя кремния, лежащего на диэлектрике является весьма сложной технологической задачей, для решения которой необходимо обеспечить требуемый закон распределения величин абразивного изнашивания по обрабатываемой поверхности.
В общем случае величина износа в произвольно выбранной точке ai обрабатываемой поверхности за время обработки t может быть определена путем интегрирования выражения для скорости изнашивания при абразивной доводке или химико-механическом полировании:
| (1) |
где ![]() – скорость абразивного изнашивания, мкм/c;
– скорость абразивного изнашивания, мкм/c;
k0 – постоянный коэффициент;
V – величина скорости абразивной среды относительно изнашиваемой поверхности, м/с;
P(1) – давление, Н/м2;
ρ – плотность абразивной среды, кг/м2;
T – температура обработки;
pH – водородный показатель.
Формула (1) для каждой конкретной схемы и условий обработки приводится к частному виду с учетом распределения величин V,P, ρ, pH, T в зоне контакта обрабатываемой поверхности и инструмента.
Следует отметить, что процессы доводки и полирования имеют статистическую природу, характеризуясь массовым динамическим воздействием абразивных зерен на обрабатываемую поверхность, поэтому под символами V, P(1), ρ, pH, T подразумеваются средние значения величин в окрестности точки ai.
Расчет распределения величин линейного износа по обрабатываемой поверхности можно существенно облегчить, если известна величина линейного износа хотя бы в одной точке a1 обрабатываемой поверхности. Тогда для расчета распределения величин линейного износа по обрабатываемой поверхности достаточно провести расчет соотношений Ui/U1, где Ui – величина износа в произвольно выбранной точке обрабатываемой поверхности. Такой подход позволяет исключить из рассмотрения коэффициент k0, зависящий от постоянных технологических факторов.
Предложенная методика применялась для расчета распределения величин линейного износа по обрабатываемой поверхности для некоторых схем оборудования с учетом действия геометрических и кинематических факторов, распределения давления в зоне контакта деталь-инструмент, распределения плотности абразивной среды pH = const; T = const. Однако при неоднородном распределении этих величин, можно промоделировать поля pH и Т и учесть их в расчете [3].
Результаты расчетов распределения величин линейного износа вдоль радиуса обрабатываемой подложки для рассматриваемых схем и условий обработки позволят установить степень влияния каждого из рассмотренных факторов и подобрать расчетным путем режим обработки обеспечивающий заданный закон распределения величин линейного износа по поверхности подложек.
Разработанные рекомендации по рациональному выбору режимов финишной обработки подложек могут быть использованы при проектировании оборудования, инструментов, а также при расчете наладок существующего оборудования для алмазно-абразивной доводки и химико-механического полирования.
Список литературы
1. Варадан В, Виной К, Джозе К. ВЧ МЭМС и их применение. Сер. Мир электроники. Пер. с англ. М.: Техносфера, 2004. 528 с.
2. Нестеров Ю.И., Скворцов К.Ф., Холевин В.В. Прогрессивные методы финишной обработки монокристаллических подложек ИС. Труды МВТУ. 1980, №331.Технологические проблемы производства электронно-вычислительной аппаратуры. С. 20-39.
3. Холевин В.В. Исследование процесса химико-механического полирования деталей и узлов микросистемной техники //technomag.edu.ru:Наука и Образование: электронное научно-техническое издание.2011. выпуск10. URLhtpp://technomag.edu.ru/issue/207707.html (дата обращения 10.10.11.)
Публикации с ключевыми словами: износ, планаризация поверхности подложек, химико-механическое полирование
Публикации со словами: износ, планаризация поверхности подложек, химико-механическое полирование
Смотри также:
Тематические рубрики:
| Авторы |
| Пресс-релизы |
| Библиотека |
| Конференции |
| Выставки |
| О проекте |
| Телефон: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) |
|
||||
| © 2003-2024 «Наука и образование» Перепечатка материалов журнала без согласования с редакцией запрещена Тел.: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) | |||||




